目前有关BGA焊接主要提到的是成功率,实际上成功率并不能真实反应焊接的情况。我们认为单纯强调成功率有一定的欺骗性,焊接成功率会存在假象,这至少包括5种情况:
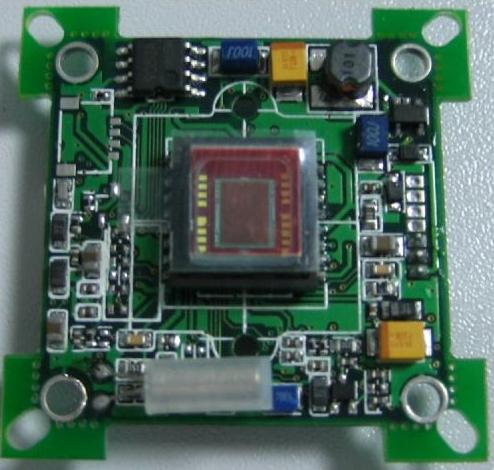
① 未焊接。有相当一部份虚焊的主板可以不通过焊接就能排除故障,比如在恒温箱里烘烤几小时,就有一部份虚焊故障可以排除。类似的情况在返修台上也会出现,通过高温加热即使锡球没有熔化(当然不能算焊接),也可排除一部份故障。
② 部份锡球只加热到临界状态。焊锡处于临界状态时,颜色发乌,当它凝固后,只能附着在焊点上,并且一旦受力就会与焊点脱离。
③ 芯片焊的不平。如果焊接中主板出现变形,或锡球熔化不均匀,就可能出现这种情况。从芯片边缘看芯片边缘并不能与主板平行,部份锡球补压扁、部份锡球被拉长。
④ PCB板老化破坏严重。
⑤ 虽然锡球熔化均匀,但与焊点焊接不实。
出现以上几种情况,虽然故障可能暂时排除,但是共同的特点是维修后的主板用不久,可能会很快返修回来。以上几种情况都与返修台和操作方法有关。要注意操作方法和一些细节处理。为了避免上述几种情况出现,检查锡球是否熔化和锡球熔化后的操作处理必不可少,在任何返修台上傻瓜式焊接都保证不了焊接质量。